PCB,即 Printed Circuit Board 的缩写,中文译为印制电路板,它包括刚性、挠 性和刚-挠结合的单面、双面和多层印制板,如下图所示。

PCB为电子产品最重要的基础部件,用做电子元件的互连与安装基板,如下图所示。
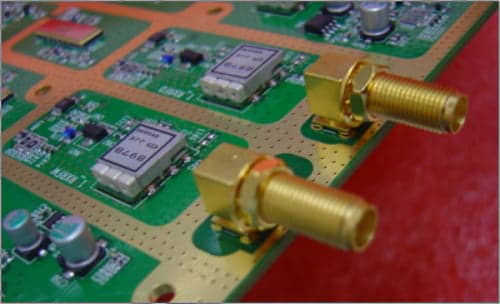
不同类别的 PCB,其制造工艺也不尽相同,但基本原理与方法却大致一样,如 电镀、蚀刻、阻焊等工艺方法都要用到。在所有种类的 PCB 中,刚性多层 PCB 应 用最广,其制造工艺方法与流程最具代表性,也是其他类别 PCB 制造工艺的基础。
了解PCB的制造工艺方法与流程,掌握基本的PCB制造工艺能力,是做好PCB可制造性设计的基础。
刚性多层PCB
本节内容,我们将简单介绍传统刚性多层 PCB 和高密度互连 PCB 的制造方法 与流程以及基本工艺能力。
刚性多层 PCB 是目前绝大部分电子产品使用的 PCB,其制造工艺具有一定的代 表性,也是 HDI 板、挠性板、刚-挠结合板的工艺基础。
1)工艺流程
刚性多层PCB制造流程如下图所示,可以简单分为内层板制造、叠层/层压、 钻孔/电镀/外层线路制作、阻焊/表面处理四个阶段,详细后面的图所示。

阶段一:内层板制作工艺方法与流程如图示。

阶段二:叠层/层压工艺方法与流程如图示
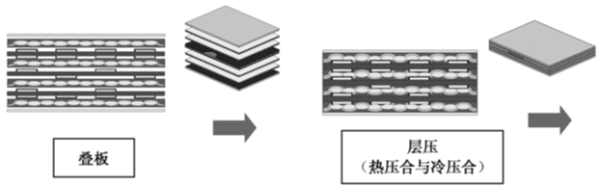
阶段三:钻孔/电镀/外层线路制作工艺方法与流程如图所示。
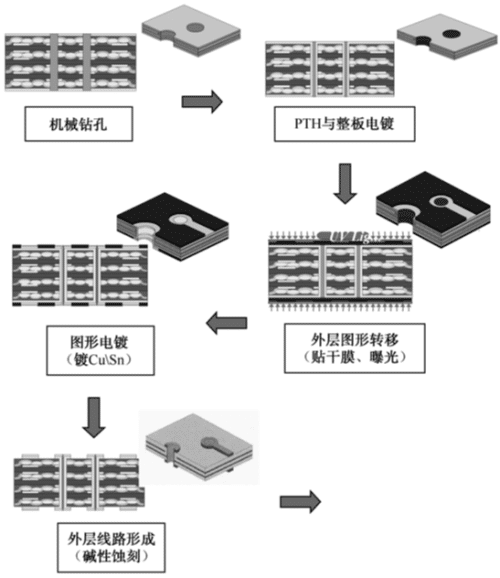
阶段四:阻焊/表面处理工艺方法与流程如图所示。
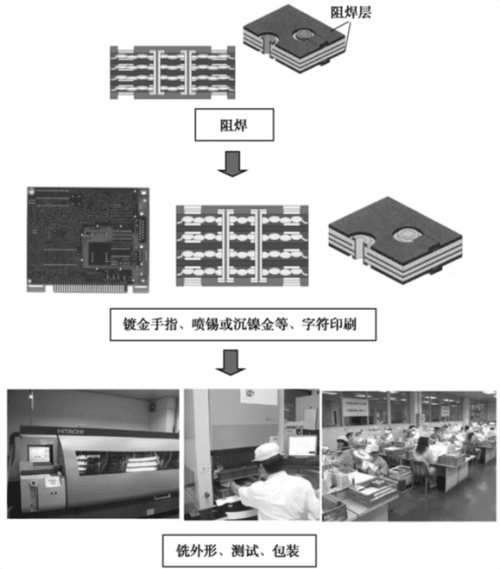
2)工艺能力
刚性多层板的工艺能力源于厂家,包括一般加工能力与加工精度。
- (1)最大层数:40。
- (2)PCB 尺寸:584mm×1041mm。
- (3)最大铜厚:外层 4OZ,内层 4OZ。
- (4)最小铜厚:外层 1/2OZ,内层 1/3OZ。
- (5)最小线宽/线距:0.10mm/0.10mm。
- (6)最小钻孔孔径:0.25mm。
- (7)最小金属化孔孔径:0.20mm。
- (8)最小孔环宽度:0.125mm。
- (9)最小阻焊间隙与宽度:0.75mm/0.75mm。
- (10)最小字符线宽:0.15mm。
- (11)外形公差:±0.10mm(与尺寸有关)。
HDI板
随着 0.8mm 及其以下引线中心距 BGA、BTC 类元器件的使用,传统的层压印制 电路制造工艺已经不能适应微细间距元件的应用需要,从而开发了高密度互连(HDI)电路板制造技术。
所谓 HDI 板,一般是指线宽/线距小于等于 0.10mm、微导通孔径小于等于 0.15mm的PCB。
在传统的多层板工艺中,所有层一次性堆叠成一块 PCB,采用贯通导通孔进行层间连接,而在 HDI 板工艺中,导体层与绝缘层是逐层积层,导体间是通过微埋/ 盲孔进行连接的。因而,一般把 HDI 板工艺称为积层工艺(BUP,Build-up Process 或 BUM,Build-up Mutiplayer )。根据微埋/盲孔导通的方法来分,还可以进一步 细分为电镀孔积层工艺和应用导电膏积层工艺(如 ALIVH 工艺和 B2IT 工艺)。
1.HDI 板的结构
HDI 板的典型结构是“N+C+N”,其中“N”表示积层层数,“C”表示芯板,如图所示。随着互连密度的提高,全积层结构(也称任意层互连)也开始使用。

2.电镀孔工艺
在HDI板的工艺中,电镀孔工艺是主流的一种,几乎占HDI板市场的95%以上。
它本身也在不断发展中,从早期的传统孔电镀到填孔电镀,HDI 板的设计自由度 得到很大提高,如图所示。

1)工艺流程
电镀孔积层工艺核心流程如图所示。

2)工艺能力
电镀孔积层板的设计,主要考虑积层的层数以及埋孔、微盲孔的结构和微盲孔 的尺寸。设计要求比较多,在此不详细说明,仅举例说明。
- (1)微盲孔的结构至少有 12 种,比如“二阶微孔+次外层机械埋孔”,设计时 请参考有关标准,如 IPC-2226(高密度互连印制板设计规范)、IPC-2315(高密 度互连与微导通孔设计导则)等。
- (2)积层介质厚度(h):40~80μm(决定了微盲孔的直径)。
- (3)微盲孔尺寸(见下图)。
- 微盲孔孔径(B):≥0.10mm,一般取 0.125mm。
- 微盲孔孔盘直径(A):≥0.30mm。
- 微盲孔捕获盘直径(C):≥0.30mm。
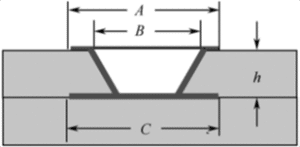
3.ALIVH 工艺
此工艺为松下公司开发的全积层结构的多层 PCB 制造工艺,是一种应用导电胶
的积层工艺,称为任意层填隙式导通互连技术(Any Layer Interstitial Via Hole, ALIVH),它意味着积层的任意层间互连全由埋/盲导通孔来实现。工艺的核心是 导电胶填孔。
ALIVH 工艺特点: 1)使用无纺芳酰胺纤维环氧树脂半固化片为基材; 2)采用 CO2 激光形成导通孔,并用导电膏填充导通孔。 ALIVH 工艺流程如图所示。
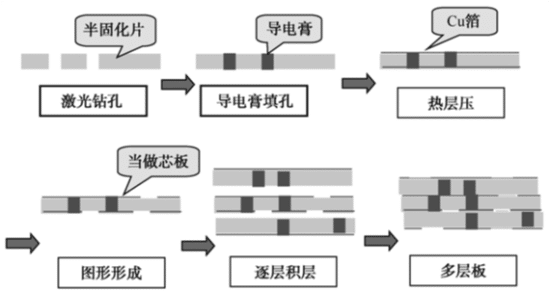
4.B2IT 工艺
此工艺为东芝公司开发的积层多层板制造工艺,这种工艺称为埋入凸块互连技术(Buried Bump Interconnection Techonology,B2IT)。工艺的核心是应用导电膏 制成的凸块。
B2IT工艺流程如图所示。

以上内容是PCB印制电路板制造工艺,作为SMT贴片加工厂需要对pcb来料有一个大致的了解,方便在今后的SMT工艺中分析生产中遇到问题有一个理论基础。

